《激光与光电子学进展》于2022年第9期(5月)推出“光刻技术”专题,其中中国科学院上海光学精密机械研究所林楠研究员团队特邀综述“极紫外光刻光源的研究进展及发展趋势”被选为本期封底文章。
文章总结了极紫外光源在大规模集成电路制造上的工业应用进展,并分析了光源关键模块所遇到的关键科学和技术问题,结合国内外的研究成果展望了未来的研究方向。

封面解读
封面形象示意了极紫外(EUV)光刻机光源基本原理:预、主脉冲分别与靶材作用产生极紫外光,后者被收集镜收集,经过光谱纯化传输至光刻系统以曝光晶圆。EUV光源是EUV光刻机中最核心的分系统之一,是下一代大规模工业化量产工艺制程的必备技术。
1背景
集成电路自发明以来被应用到了各行各业中,并迅速将人类从工业社会带到信息社会,集成电路的发明者 Jack Kilby 也因此获得了 2000 年诺贝尔物理学奖。集成电路或芯片是通过光刻(Lithography)在硅晶圆上逐层构建复杂的晶体管图案制成。
光刻系统本质上是一种投影系统,依靠对光的精准控制,通过光化学反应将事先制备好的掩模(Mask)缩小并转印到硅晶圆上。光刻机作为集成电路工业发展的重要支柱设备之一,是整个半导体产业发展的主要技术支撑。目前EUV光刻机已广泛应用于大规模量产,是未来工艺制程延续的保障。EUV 光源是其中最为核心的分系统之一,也是 EUV 光刻机实现稳定运行的最大难点。激光等离子体(LPP)是目前产生极紫外光的主流方案。
2 EUV光刻光源技术
LPP工作原理是通过高强度的激光与靶材的相互作用,使靶材吸收层被加热气化并产生等离子体。由于逆轫致吸收(IBA)等离子体持续被加热并辐射出包含13.5nm的复合光,通过收集、滤波得到中心波长为13.5nm、带宽为2%的极紫外光源。

图1 商用化激光等离子体极紫外EUV光源双脉冲方案的原理图
商用化EUV光刻机光源采用了双脉冲激发方案[1-2],如图1所示。其作用过程可以分为:1)锡液滴产生器将大小适宜且高速稳定的锡液滴供给到作用区域;2)预脉冲激光精准轰击迅速通过的锡液滴使其扩散成适宜的形状分布;3)主脉冲激光轰击,通过激光激发等离子体物理机制产生极紫外光;4)产生的极紫外光被收集镜收集,经过光谱纯化传输至光刻系统以曝光晶圆。

图2 LPP光源系统架构示意图[3]
商用化LPP EUV光源的整体架构图如图2所示,其核心模块主要包括驱动激光、光束控制传输模块、真空系统、液滴锡靶产生器、收集镜、污染控制模块。针对商用化LPP技术,分别从驱动光源、液滴锡靶、收集镜三大核心子模块展开介绍,剖析了EUV光源的核心技术难点。
LPP驱动光源
为了能够达到有效产生EUV所需的单脉冲能量和平均功率,CO2激光成为了业界主流的LPP驱动光源。功率放大采用了振荡器功率放大器(MOPA)技术,如图3所示,主泵浦CO2系统结构主要由振荡器、隔离器、预放大器和主放大器构成。主泵浦CO2激光,采用了主振荡功率放大,即由振荡器产生高重频、短脉冲CO2种子光,经多级CO2激光放大器实现功率放大。

图3 MOPA技术的原理示意图[4]
液滴靶材
液滴锡靶已成为当前LPP方式产生EUV光的主流靶材,而液滴锡的产生装置需要按照一定频率,稳定、连续地产生具有一定间距且大小均匀的液滴,从而使激光辐照锡靶后能稳定地获得较高的CE。目前主要有两种产生液滴的方式:按需液滴(Droplet on Demand)方式和瑞利射流断裂方式(Rayleigh Jet Breakup),对应的液滴发生器分别为按需液滴发生器和连续液滴流发生器,如图4和5所示。
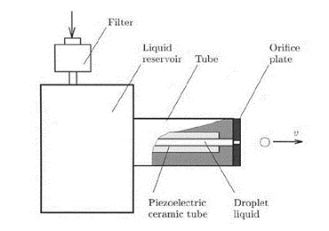
图4 按需液滴发生器的示意图[5]

图5 连续液滴流发生器示意图[6]
收集镜多层膜的制备
目前制备多层膜的方法主要有电子束蒸发、离子束溅射和磁控溅射,制备过程中的膜层厚度由软X射线反射仪控制。对于大曲面光学器件的镀膜,电子束蒸发、离子束抛光和磁控溅射相结合是实现高反射率横向梯度多层膜最合适的沉积方法。电子束蒸发与离子束抛光的组合在一些设备中已经得到应用。如由ASML和卡尔蔡司合作制作的第一代商用EUV光刻机NXE:3100[7]。采用磁控溅射技术进行横向梯度多层膜制备的方法较为成熟,且有大量研究结合实际工艺对矩形和圆形磁控溅射靶源的溅射产额进行分析。该方法被广泛应用于大面积曲面镀膜,有效提高了镀膜效率,同时对于界面层和表面保护层制备时的厚度控制也是有利的。荷兰FOM研究所与德国莱博尔德光学公司合作研发的热化粒子磁控管沉积Mo/Si多层膜的实验中,13.5 nm波长下EUV的最高反射率达70.15%[8]。
3 高CE技术及收集镜寿命维护
高CE技术
LPP光源系统的CE非常重要,百瓦功率EUV光的生成需要使用万瓦功率的激发光。提出从改变驱动光源波长、使用双激光脉冲作用、激发光光场的时空(完美波形)控制、锡靶大小形状及激发光射击锡靶过程的时空同步控制等方面来提高CE。
光源污染与防护
光源污染主要有碳污染、氧化污染和碎屑污染。提升收集镜反射率需在制备过程中引入超高真空环境和抗氧化层。极紫外光刻机中收集镜距锡靶很近,在运行过程中会对Mo/Si多层膜光学元件表面造成污染,降低收集镜的反射率及使用寿命,影响光刻机的正常使用。碳污染清洗技术包括等离子体清洗技术、活性氧清洗技术和原子氢清洗技术。碎屑缓解技术目前常用的缓解碎屑方法有缓冲气体法和磁场法。有限的磁场可以减缓碎屑速度但无法完全阻挡其到达收集镜表面,而缓冲气体和磁场的组合可以最大程度地减缓碎屑速度,还能减小缓冲气体的压强,且对光子辐射的吸收最小。
4 总结与展望
目前,荷兰ASML公司使用重复频率50 kHz、功率为21.5 kW的CO2激发光产生250 W稳定的EUV光输出,可用于7 nm节点光刻曝光。对于未来3 nm及其以下节点的曝光光刻,EUV光源的功率至少需要500 W, EUV光源技术仍有较大的提升和改进空间。
通过国内研究人员的不断努力,积极的学习与借鉴国外先进技术,加之强大的综合国力支持,我国的光刻技术和半导体产业必将进入发展的快车道并逐步缩短与国际先进水平的差距。
参考文献
[1] van de Kerkhof M A, Liu F, Meeuwissen M, et al. Spectral purity performance of high-power EUV systems[J]. Proceedings of SPIE, 2020, 11323: 1132321.
[2] Mizoguchi H, Nakarai H, Abe T, et al. High power LPP-EUV source with long collector mirror lifetime for high volume semiconductor manufacturing[C]//2018 China Semiconductor Technology International Conference (CSTIC), March 11-12, 2018, Shanghai, China. New York: IEEE Press, 2018: 17805561.
[3] Bakshi V. EUV lithography[M]. 2nd ed. Bellingham: SPIE Press, 2018.
[4] Michael P. An introduction to EUV sources for lithography[EB/OL]. (2019-09-25)[2022-02-18]. https://strobe.colorado.edu/wp-content/uploads/STROBE_ASML-EUV-Sources_Purvis_25-Sept-2020-1.pdf.
[5] Frohn A, Roth N. Dynamics of droplets[M]. Berlin: Springer, 2000: 63-83.
[6] Pirati A, Peeters R, Smith D, et al. EUV lithography performance for manufacturing: status and outlook[J]. Proceedings of SPIE, 2016, 9776: 97760A.
[7] Louis E, van Hattum E D, van der Westen S A, et al. High reflectance multilayers for EUVL HVM-projection optics[J]. Proceedings of SPIE, 2010, 7636: 76362T.
[8] Yakshin A E, van de Kruijs R W E, Nedelcu I, et al. Enhanced reflectance of interface engineered Mo/Si multilayers produced by thermal particle deposition[J]. Proceedings of SPIE, 2007, 6517: 158-166.